X-RAY在BGA焊接質量檢驗中的應用
2016-03-21 瀏覽量:4478
摘要
本文主要介紹了X-RAY在BGA焊接質量檢驗中的應用。
關鍵詞
X-RAY,BGA,檢驗,IPC-A-610E,GJB 548B
前言
作為小型器件典范的BGA器件近些年來在電子產品中應用非常廣泛,與QFP封裝器件或PLCC封裝器件相比,BGA器件具有引腳數目更多、引腳間電感及電容更小、引腳共面性好、電性能及散熱性能好等諸多優點。雖然BGA器件有諸多方面的優點,但仍存在著無法改變的不足之處:即BGA器件在焊接完成之后,由于其焊點全部在器件本體腹底之下,因此既無法采用傳統的目測方法觀測檢驗全部焊點的焊接質量,也不能應用AOI(自動光學檢驗)設備對焊點外觀做質量評判,目前通用的方式均采用X-ray檢驗設備對BGA器件焊點的物理結構進行檢驗。
X-RAY檢驗原理
X-ray檢驗設備是基于X射線的影像原理,由X射線發生裝置發出X射線,對被檢驗印制板組及BGA器件進行照射,利用X射線不能穿透錫、鉛等密度大且厚的物質,可形成深色影像,而會輕易穿透印制板及塑料封裝等密度小且薄的物質,不會形成影像的現象,實現對BGA器件焊接焊點的質量檢驗。X-RAY檢測原理如下圖所示:
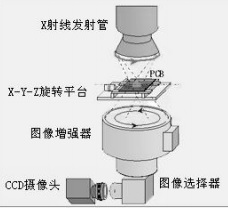 |
 |
焊點缺陷
a. 焊點缺陷種類
BGA器件焊點缺陷主要有焊料橋連、焊錫珠、空洞、錯位、開路和焊料球丟失、焊接連接處破裂、虛焊等。
b.焊料橋連
由于焊料橋連最終導致的結果就是電氣短路,因此BGA器件焊接后,各相鄰焊料球之間應無焊料橋連。這種缺陷在采用X-ray檢驗設備檢驗時比較明顯,在影像區內可見焊料球與焊料球之間呈現連續的連接,容易觀察和判斷。
c.焊錫珠
焊錫珠是表面貼裝過程中的主要缺陷之一,造成焊錫珠的原因有很多。這種缺陷在X-ray影像區內也易于識別,應用X-ray檢驗設備觀察測量焊錫珠時,應主要注意其尺寸要求和位置要求,并且不違反最小電氣間隙要求。
d.空洞
空洞在BGA器件焊接后是最常見的,因為往往許多BGA器件本身的焊料球就可能帶有空洞或氣孔,在回流焊接過程中,回流曲線設置不合理則更容易產生空洞。GJB 4907-2003與IPC-A-610E標準均對空洞做出了評判準則,但評判尺度存在差異。其中GJB 4907-2003中規定焊點空洞應不大于焊點體積的15%,而IPC-A-610E中規定X-ray影像區內任何焊料球的空洞應不大于25%。
e.虛焊
一般虛焊都是由于回流焊接過程不充分造成的。在回流焊接過程中,焊料球與錫膏沒有形成良好地熔融,無法形成潤濕良好的共晶體。虛焊是一種不容忽視的缺陷,容易造成器件脫落,影響器件的電氣性能。虛焊缺陷也必須通過旋轉X射線角度進行檢驗,從而及時采取有效措施避免它的發生。
典型圖片
| 檢測項目 | 圖示 | 標準 |
| BGA短路 | 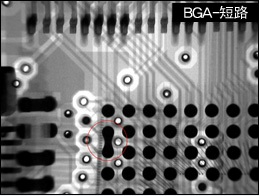 |
BGA錫球短路會造成功能性不良。 |
| BGA空洞 |  |
BGA錫球氣孔,氣孔大小不能超過球體20%。 |
| BGA錫球開裂 | 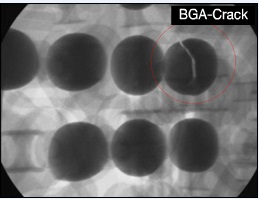 |
BGA錫球,可靠性不牢判為拒收 |
小結:
利用X-ray檢驗設備對BGA器件焊接質量進行檢驗是一種高性價比的檢驗手段。隨著新技術的發展,超高分辨率、智能化的X-ray檢驗設備不僅會為BAG器件組裝提供省時、省力、可靠的保障,也能夠在電子產品故障分析中扮演重要的角色,提高故障排查效率。
參考文獻
IPC-A-610E 電子組裝件的驗收標準
GJB 548B-2005 微電子器件試驗方法和程序
GJB 4907-2003 球柵陣列封裝器件組裝通用要求
李柏東,《淺談X—ray檢驗設備評判BGA器件焊接質量》,《科技創新與應用》2014年第24期
*** 結束 ***
- 聯系我們
深圳美信總部
熱線:400-850-4050
蘇州美信
熱線:400-118-1002
北京美信
熱線:400-850-4050
東莞美信
熱線:400-850-4050
廣州美信
熱線:400-850-4050
柳州美信
熱線:400-850-4050
寧波美信
熱線:400-850-4050
西安美信
熱線:400-850-4050

