切片分析技術(shù)在電子產(chǎn)品微觀結(jié)構(gòu)中的全應用!
電子產(chǎn)品高集成化、微型化發(fā)展,電子封裝高精密度、小型化、PCBA高密度互連帶來的精細導線化和微小孔徑化,使得對檢測方法和技術(shù)提出了更嚴格的要求。切片分析技術(shù)在電子產(chǎn)品微觀檢測方面應用廣泛,起到重要作用!
通常被用作電子產(chǎn)品的品質(zhì)判定和品質(zhì)異常分析、檢驗電路板品質(zhì)的好壞、PCBA焊接質(zhì)量檢測、尋找失效的原因與解決方案、評估制程改進,作為客觀檢查、研究與判斷的根據(jù)。
在微觀結(jié)構(gòu)的分析過程中,切片分析是一項很重要的分析手段。首先,我們來了解一下什么是切片分析,它的形式、檢測步驟及用途等。
切片分析
金相切片技術(shù)是用特制液態(tài)熱固性樹脂將樣品鑲嵌包裹固封,并對鑲嵌的樣品研磨拋光,然后在金相顯微鏡下觀察檢測樣品剖面的一種失效分析技術(shù)。
形式分類
切片按研磨方向分為垂直切片和水平切片兩種。
1. 垂直切片即沿垂直于板面的方向切開,觀察剖面狀況。垂直切片是切片分析中最常用的方式。
2. 水平切片是順著板子的疊合方向一層層向下研磨,用來觀察每一層面的狀況,通常用來輔助垂直切片進行品質(zhì)異常的分析判定。
在開始實驗前,我們需要通過初步判斷選擇進行哪種類型的切片方法才可以更加快捷準確地發(fā)現(xiàn)問題。
檢測步驟
取樣→清洗→真空鑲嵌→研磨→拋光→微蝕(如有必要)→觀察
使用儀器
精密切割機,鑲樣系統(tǒng),真空箱,研磨及拋光機,金相顯微鏡,電子顯微鏡等。
依據(jù)標準
IPC-TM 650 2.1.1, IPC-TM 650-2.2.5 , IPC A 600, IPC A 610等。
主要用途
1、切片后的樣品常用體視顯微鏡或者金相顯微鏡觀察;
2、切片后的樣品可以用SEM/EDS掃描電鏡與能譜觀察形貌與分析成分;
3、做完無損檢測如x-ray,C-SAM的樣品所發(fā)現(xiàn)的疑似異常開裂、異物嵌入等情況,可以用切片的方法來觀察驗證;
4、切片后的樣品可以與FIB聯(lián)用,做更細微的顯微切口觀察。
切片分析在PCB和SMT行業(yè)的應用十分廣泛,它能夠有效監(jiān)控產(chǎn)品的內(nèi)在品質(zhì),找出問題的原因,協(xié)助問題的解決。適用于PCB板品質(zhì)檢測和制程改善,電子元器件結(jié)構(gòu)剖析,PCBA焊接可靠性評定,焊點上錫形態(tài)及缺陷檢測等。
那么,切片分析技術(shù)到底在電子產(chǎn)品的微觀缺陷的檢測及微觀結(jié)構(gòu)的觀察方面是如何應用的呢?接下來,我們詳細解答并附上典型案例圖示!
一、電子產(chǎn)品的微觀表面或內(nèi)部結(jié)構(gòu)缺陷觀察
電子元器件、pcb結(jié)構(gòu)缺陷觀察。利用切片方法可對體積較小的樣品放大觀察,以檢測電子元器件關(guān)鍵位置中的孔洞、針孔、吹孔、裂紋等缺陷;檢測PCB的分層,孔銅斷裂等缺陷。
典型案例圖示
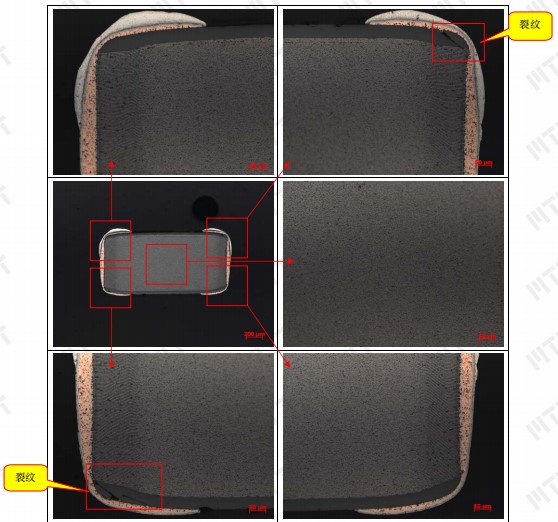
(貼片電容開裂失效)
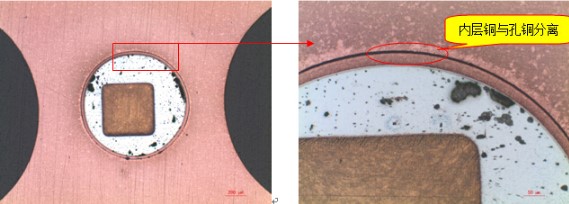
(PHT內(nèi)層銅分離)

(PCB內(nèi)層結(jié)構(gòu)開裂)
二、PCB/PCBA焊接檢測
a. BGA空焊,虛焊,孔洞,橋接,上錫面積等;

(BGA錫球假焊/虛焊)
b. 檢查PCB內(nèi)部導線厚度、層數(shù)、通孔孔徑大小、通孔質(zhì)量觀察,用于檢查PCBA焊點內(nèi)部空洞,界面結(jié)合狀況,潤濕質(zhì)量評價等。如:電容與PCB銅箔層數(shù)解析,LED結(jié)構(gòu)剖析,電鍍工藝分析,材料內(nèi)部結(jié)構(gòu)缺陷等;
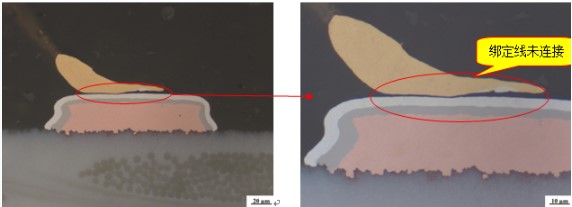
(LED燈中綁定線未連接)
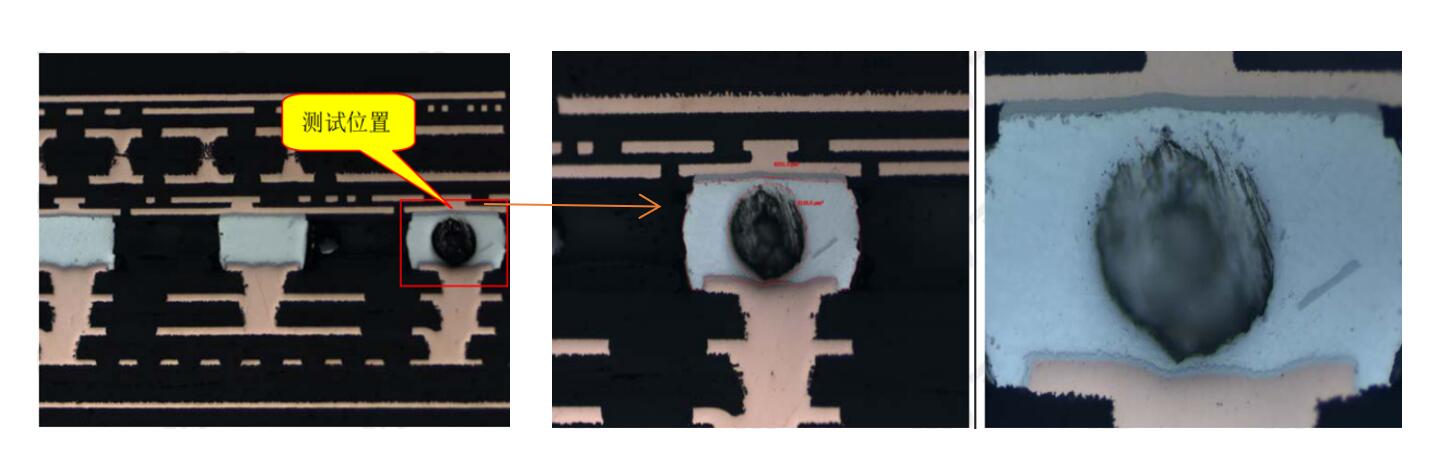
(PCBA焊點潤濕良好,孔洞明顯)
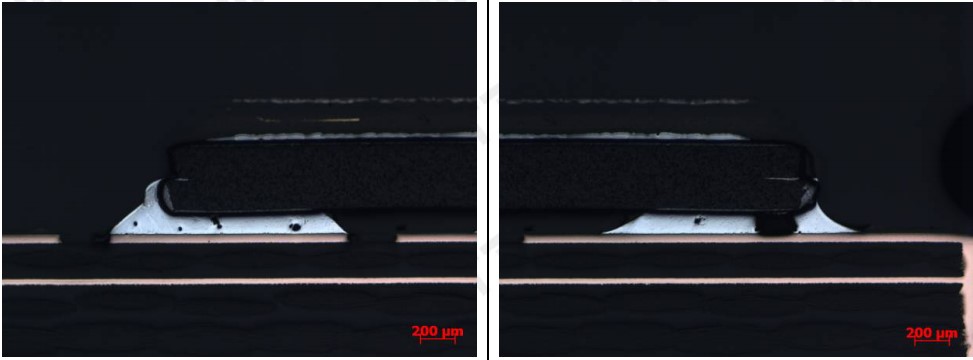
(攝像頭基板焊點孔洞觀察)
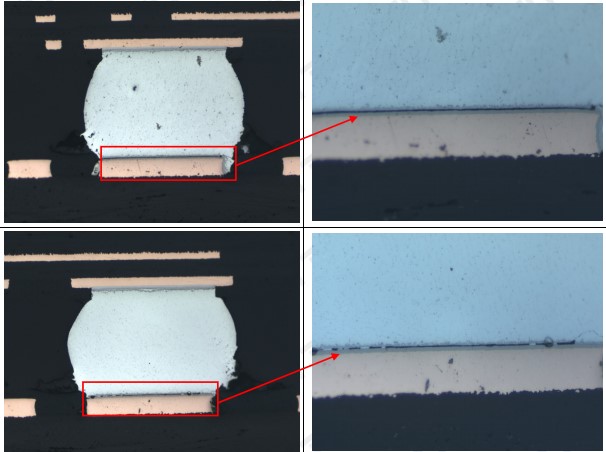
(主板焊接界面結(jié)合狀況)
c.微小尺寸量測(一般大于1μm):氣孔大小,上錫高度,銅箔厚度等。
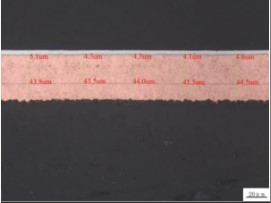 |
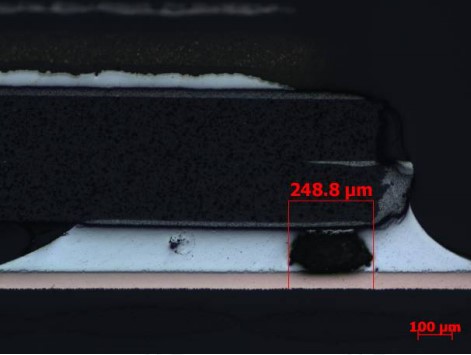 |
| (PCB銅層厚度) | (焊點孔洞尺寸) |
三、是電子產(chǎn)品失效分析中的重要一環(huán)
1.觀察分析單個樣品的品質(zhì),發(fā)現(xiàn)產(chǎn)品問題,從而進行相應的改善。
2.不同批次、同一批次不同型號產(chǎn)品出現(xiàn)失效,通過切片分析,了解產(chǎn)品失效機理,從而找出其失效原因,并找到相應的解決方案,以提升良率并降低損失。
典型案例
某PCBA在組裝完成后,存在LED器件脫落,掉件不良現(xiàn)象。
為找到失效的根本原因,我們對客戶提供的失效樣品和OK樣品進行了對比分析,通過外觀檢查、表面分析、切片分析、模擬驗證、AES分析等測試項目進行詳細剖析。
其中切片分析是將NG樣品和OK樣品分別制作切片,了解焊點界面狀態(tài),而后利用SEM+EDS對兩個樣品進行觀察分析,得出結(jié)論:
NG樣品出現(xiàn)失效焊點開裂的直接原因是焊料與鎳層之間未能形成良好的IMC層,從而使得焊點界面在受應力作用下容易發(fā)生開裂。
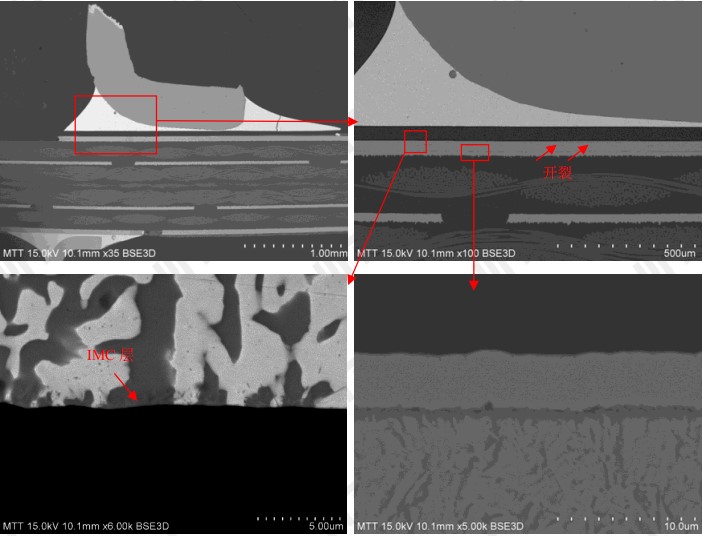
(NG樣品的切片分析)
.jpg)
(OK樣品的切片分析)
綜上所述,我們可以知道,利用金相切片分析直觀精確地檢測出產(chǎn)品的失效模式,及時發(fā)現(xiàn)內(nèi)部潛在缺陷,防止問題擴大化和資源的浪費。利用金相切片分析對生產(chǎn)過程進行監(jiān)控,不僅只是用于回流后焊點檢測,還可以對來料進行監(jiān)控,及時發(fā)現(xiàn)來料規(guī)格是否符合標準,以預防生產(chǎn)中不良產(chǎn)品產(chǎn)生。
- 了解更多
- 資質(zhì)證書
- 專家介紹
- 聯(lián)系我們
- 聯(lián)系我們
深圳美信總部
熱線:400-850-4050
蘇州美信
熱線:400-118-1002
北京美信
熱線:400-850-4050
東莞美信
熱線:400-850-4050
廣州美信
熱線:400-850-4050
柳州美信
熱線:400-850-4050
寧波美信
熱線:400-850-4050
西安美信
熱線:400-850-4050

