先進材料表征方法
| X射線能譜分析(EDS) | 聚焦離子束分析(FIB) | 俄歇電子能譜分析(AES) | X射線光電子能譜分析(XPS) |
| 動態二次離子質譜分析(D-SIMS) | 飛行時間二次離子質譜分析(TOF-SIMS) | ||
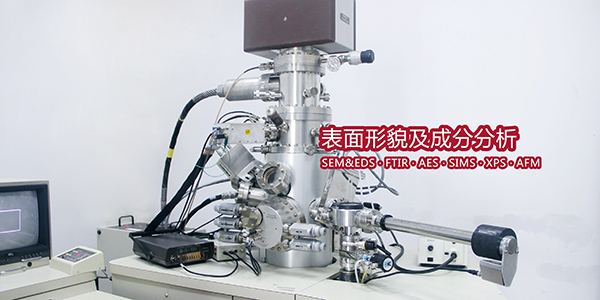
1.俄歇電子能譜技術(AES)
俄歇電子能譜技術(Auger electron spectroscopy,簡稱AES),是一種表面科學和材料科學的分析技術,因檢測由俄歇效應產生的俄歇電子信號進行分析而命名。這種效應系產生于受激發的原子的外層電子跳至低能階所放出的能量被其他外層電子吸收而使后者逸出,這一連串事件稱為俄歇效應,而逃脫出來的電子稱為俄歇電子,通過檢測俄歇電子的能量和數量來進行定性定量分析。AES應用于鑒定樣品表面的化學性質及組成的分析,其特點在俄歇電子來極表面甚至單個原子層,僅帶出表面的化學信息,具有分析區域小、分析深度淺和不破壞樣品的特點,廣泛應用于材料分析以及催化、吸附、腐蝕、磨損等方面的研究。
2. 俄歇電子能譜分析(AES)可為客戶解決的產品質量問題
(1)當產品表面存在微小的異物,而常規的成分測試方法無法準確對異物進行定性定量分析,可選擇AES進行分析,AES能分析≥20nm直徑的異物成分,且異物的厚度不受限制(能達到單個原子層厚度,0.5nm)。
(2)當產品表面膜層太薄,無法使用常規測試進行厚度測量,可選擇AES進行分析,利用AES的深度濺射功能測試≥3nm膜厚厚度。
(3)當產品表面有多層薄膜,需測量各層膜厚及成分,利用D-SIMS結合AES能準確測定各層薄膜厚度及組成成分。
3. 俄歇電子能譜分析(AES)注意事項
(1)樣品最大規格尺寸為1×1×0.5cm,當樣品尺寸過大需切割取樣。
(2)取樣的時候避免手和取樣工具接觸到需要測試的位置,取下樣品后使用真空包裝或其他能隔離外界環境的包裝, 避免外來污染影響分析結果。
(3)由于AES測試深度太淺,無法對樣品噴金后再測試,所以絕緣的樣品不能測試,只能測試導電性較好的樣品。
(4)AES元素分析范圍Li-U,只能測試無機物質,不能測試有機物物質,檢出限0.1%。
4.應用實例
樣品信息:樣品為客戶端送檢LED碎片,客戶端反映LED碎片上Pad表面存在污染物,要求分析污染物的類型。
失效樣品確認:將LED碎片放在金相顯微鏡下觀察,尋找被污染的Pad,通過觀察,發現Pad表面較多小黑點。
.jpg)
俄歇電子能譜儀( AES)分析:對被污染的Pad表面進行分析,結果如下圖,位置1為污染位置,位置2為未污染位置。
.jpg) |
.jpg) |
結論:通過未污染位置和污染位置對比分析,發現污染位置主要為含K和S類物質,在未污染位置只發現S和O,推斷污染位置存在K離子污染,并接觸含S類介質,共同作用形成黑色的污染物。
| 點擊咨詢 獲取檢測方案 |
- 聯系我們
深圳美信總部
熱線:400-850-4050
蘇州美信
熱線:400-118-1002
北京美信
熱線:400-850-4050
東莞美信
熱線:400-850-4050
廣州美信
熱線:400-850-4050
柳州美信
熱線:400-850-4050
寧波美信
熱線:400-850-4050
西安美信
熱線:400-850-4050

