先進(jìn)材料表征方法
| X射線能譜分析(EDS) | 聚焦離子束分析(FIB) | 俄歇電子能譜分析(AES) | X射線光電子能譜分析(XPS) |
| 動(dòng)態(tài)二次離子質(zhì)譜分析(D-SIMS) | 飛行時(shí)間二次離子質(zhì)譜分析(TOF-SIMS) | ||
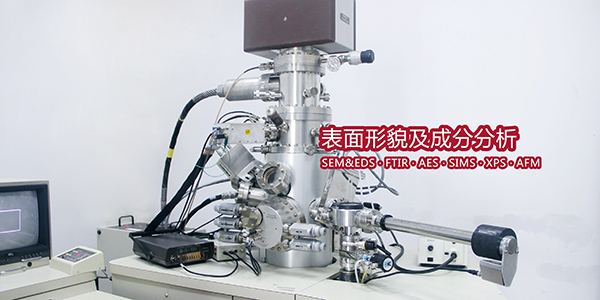
1、聚焦離子束技術(shù)(FIB)
聚焦離子束技術(shù)(Focused Ion beam,F(xiàn)IB)是利用電透鏡將離子束聚焦成非常小尺寸的離子束轟擊材料表面,實(shí)現(xiàn)材料的剝離、沉積、注入、切割和改性。隨著納米科技的發(fā)展,納米尺度制造業(yè)發(fā)展迅速,而納米加工就是納米制造業(yè)的核心部分,納米加工的代表性方法就是聚焦離子束。近年來發(fā)展起來的聚焦離子束技術(shù)(FIB)利用高強(qiáng)度聚焦離子束對材料進(jìn)行納米加工,配合掃描電鏡(SEM)等高倍數(shù)電子顯微鏡實(shí)時(shí)觀察,成為了納米級分析、制造的主要方法。目前已廣泛應(yīng)用于半導(dǎo)體集成電路修改、離子注入、切割和故障分析等。
2. 聚焦離子束技術(shù)(FIB)可為客戶解決的產(chǎn)品質(zhì)量問題
(1)在IC生產(chǎn)工藝中,發(fā)現(xiàn)微區(qū)電路蝕刻有錯(cuò)誤,可利用FIB的切割,斷開原來的電路,再使用定區(qū)域噴金,搭接到其他電路上,實(shí)現(xiàn)電路修改,最高精度可達(dá)5nm。
(2)產(chǎn)品表面存在微納米級缺陷,如異物、腐蝕、氧化等問題,需觀察缺陷與基材的界面情況,利用FIB就可以準(zhǔn)確定位切割,制備缺陷位置截面樣品,再利用SEM觀察界面情況。
(3)微米級尺寸的樣品,經(jīng)過表面處理形成薄膜,需要觀察薄膜的結(jié)構(gòu)、與基材的結(jié)合程度,可利用FIB切割制樣,再使用SEM觀察。
3. 聚焦離子束技術(shù)(FIB)注意事項(xiàng)
(1)樣品大小5×5×1cm,當(dāng)樣品過大需切割取樣。
(2)樣品需導(dǎo)電,不導(dǎo)電樣品必須能噴金增加導(dǎo)電性。
(3)切割深度必須小于50微米。
4.應(yīng)用實(shí)例
(1)微米級缺陷樣品截面制備
(2)PCB電路斷裂位置,利用離子成像觀察銅箔金相。
| 點(diǎn)擊咨詢 獲取檢測方案 |
- 了解更多
- 資質(zhì)證書
- 專家介紹
- 聯(lián)系我們
- 聯(lián)系我們
深圳美信總部
熱線:400-850-4050
蘇州美信
熱線:400-118-1002
北京美信
熱線:400-850-4050
東莞美信
熱線:400-850-4050
廣州美信
熱線:400-850-4050
柳州美信
熱線:400-850-4050
寧波美信
熱線:400-850-4050
西安美信
熱線:400-850-4050